Kode QR

Tentang Kami
Produk
Hubungi kami


Fax
+86-579-87223657

Surel

Alamat
Jalan Wangda, Jalan Ziyang, Kabupaten Wuyi, Kota Jinhua, Provinsi Zhejiang, Tiongkok
Dalam semikonduktor dan tampilan panel FPD, persiapan film tipis merupakan proses yang penting. Ada banyak cara untuk menyiapkan film tipis (TF, Thin Film), dua metode berikut ini umum digunakan:
● CVD (Deposisi Uap Kimia)
● PVD (deposisi uap fisik)
Di antara mereka, lapisan buffer/lapisan aktif/isolasi semuanya diendapkan di ruang mesin menggunakan PECVD.
● Gunakan gas khusus: SiH4/NH3/N2O untuk pengendapan film SiN dan Si/SiO2.
● Beberapa mesin CVD perlu menggunakan H2 untuk hidrogenasi guna meningkatkan mobilitas pembawa.
● NF3 adalah gas pembersih. Sebagai perbandingan: F2 sangat beracun, dan efek rumah kaca SF6 lebih tinggi dibandingkan NF3.
Dalam proses perangkat semikonduktor, ada lebih banyak jenis film tipis, selain SiO2/Si/Sin yang umum, ada juga W, Ti/Tin, HFO2, SiC, dll.
Ini juga merupakan alasan mengapa ada banyak jenis prekursor untuk bahan canggih yang digunakan dalam industri semikonduktor, untuk membuat berbagai jenis film tipis.
1. Jenis CVD dan beberapa gas prekursor
2. Mekanisme Dasar CVD dan Kualitas Film
CVD merupakan konsep yang sangat umum dan dapat dibagi menjadi banyak jenis. Yang umum adalah:
● Pecvd: Peningkatan CVD Plasma
● LPCVD: CVD Tekanan Rendah
● ALD: Deposisi lapisan atom
● MOCVD: CVD logam-organik
Selama proses CVD, ikatan kimia dari prekursor harus diputus sebelum terjadinya reaksi kimia.
Energi untuk memecahkan ikatan kimia berasal dari panas, sehingga suhu ruang akan relatif tinggi, yang tidak ramah pada beberapa proses, seperti kaca substrat panel atau bahan PI dari layar fleksibel. Oleh karena itu, dengan memasukkan energi lain (membentuk plasma, dll.) Untuk mengurangi suhu proses untuk memenuhi beberapa proses yang membutuhkan suhu, anggaran termal juga akan dikurangi.
Oleh karena itu, deposisi PECVD A-Si: H/Sin/Poly-Si banyak digunakan dalam industri tampilan FPD. Prekursor dan film CVD umum:
Silikon polikristalin/silikon kristal tunggal sio2 sin/sion w/ti wsi2 hfo2/sic
Langkah -langkah mekanisme dasar CVD:
1. Gas prekursor reaksi memasuki ruang
2. Produk perantara yang diproduksi oleh reaksi gas
3. Produk perantara gas difus ke permukaan substrat
4. Mengadsorpsi pada permukaan substrat dan tersebar
5. Reaksi kimia terjadi pada permukaan substrat, nukleasi/pembentukan pulau/pembentukan film
6. Produk sampingan didesor, vakum dipompa dan keluar setelah memasuki scrubber untuk perawatan
Seperti yang disebutkan sebelumnya, seluruh proses mencakup beberapa langkah seperti difusi/adsorpsi/reaksi. Laju pembentukan film secara keseluruhan dipengaruhi oleh banyak faktor, seperti suhu/tekanan/jenis gas reaksi/jenis substrat. Difusi memiliki model difusi untuk prediksi, adsorpsi memiliki teori adsorpsi, dan reaksi kimia memiliki teori kinetika reaksi.
Dalam keseluruhan proses, langkah paling lambat menentukan laju reaksi keseluruhan. Hal ini sangat mirip dengan metode jalur kritis manajemen proyek. Alur aktivitas terpanjang menentukan durasi proyek terpendek. Durasinya dapat dipersingkat dengan mengalokasikan sumber daya untuk mengurangi waktu perjalanan ini. Demikian pula, CVD dapat menemukan hambatan utama yang membatasi laju pembentukan film dengan memahami seluruh proses, dan menyesuaikan pengaturan parameter untuk mencapai tingkat pembentukan film yang ideal.
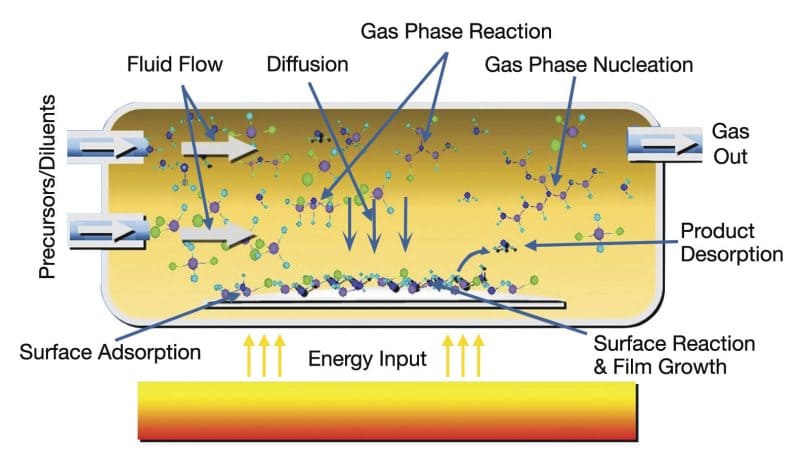
Beberapa film datar, beberapa diisi lubang, dan beberapa diisi alur, dengan fungsi yang sangat berbeda. Mesin CVD komersial harus memenuhi persyaratan dasar:
● Kapasitas pemrosesan mesin, tingkat deposisi
● Konsistensi
● Reaksi fase gas tidak dapat menghasilkan partikel. Sangat penting untuk tidak menghasilkan partikel dalam fase gas.
Beberapa persyaratan evaluasi lainnya adalah sebagai berikut:
● Cakupan langkah yang bagus
● Kemampuan untuk mengisi kesenjangan rasio aspek tinggi (konformitas)
● Keseragaman ketebalan yang baik
● Kemurnian dan kepadatan tinggi
● Tingkat kesempurnaan struktural yang tinggi dengan tekanan film yang rendah
● Sifat listrik yang baik
● Daya rekat sangat baik pada bahan substrat



+86-579-87223657


Jalan Wangda, Jalan Ziyang, Kabupaten Wuyi, Kota Jinhua, Provinsi Zhejiang, Tiongkok
Hak Cipta © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Semua Hak Dilindungi Undang-undang.
Links | Sitemap | RSS | XML | Kebijakan Privasi |
