Kode QR

Tentang Kami
Produk
Hubungi kami


Fax
+86-579-87223657

Surel

Alamat
Jalan Wangda, Jalan Ziyang, Kabupaten Wuyi, Kota Jinhua, Provinsi Zhejiang, Tiongkok
Substrat silikon karbida memiliki banyak cacat dan tidak dapat diproses secara langsung. Film tipis kristal tunggal tertentu perlu ditanam melalui proses epitaxial untuk membuat wafer chip. Film tipis ini adalah lapisan epitaxial. Hampir semua perangkat silikon karbida direalisasikan pada bahan epitaxial. Bahan epitaxial homogen silikon karbida berkualitas tinggi adalah dasar untuk pengembangan perangkat silikon karbida. Kinerja bahan epitaxial secara langsung menentukan realisasi kinerja perangkat silikon karbida.
Perangkat silikon karbida silikon yang tinggi dan high-arus telah mengedepankan persyaratan yang lebih ketat pada morfologi permukaan, kepadatan cacat, keseragaman doping dan ketebalan bahan epitaxial. Kepadatan besar, kerapatan rendah dan keseragaman tinggiEpitaks silikon karbidatelah menjadi kunci untuk pengembangan industri silikon karbida.
Persiapan berkualitas tinggiEpitaks silikon karbidaMembutuhkan proses dan peralatan canggih. Metode pertumbuhan epitaxial silikon karbida yang paling banyak digunakan adalah Chemical Vapor Deposition (CVD), yang memiliki keunggulan kontrol yang tepat dari ketebalan film epitaxial dan konsentrasi doping, cacat lebih sedikit, laju pertumbuhan sedang, dan kontrol proses otomatis. Ini adalah teknologi yang dapat diandalkan yang telah berhasil dikomersialkan.
Epitaks CVD silikon karbida umumnya menggunakan dinding panas atau peralatan CVD dinding hangat, yang memastikan kelanjutan lapisan epitaxial 4H kristal SiC dalam kondisi suhu pertumbuhan yang lebih tinggi (1500-1700 ℃). Setelah bertahun -tahun pengembangan, dinding panas atau CVD dinding hangat dapat dibagi menjadi reaktor struktur horizontal horizontal dan reaktor struktur vertikal vertikal sesuai dengan hubungan antara arah aliran gas inlet dan permukaan substrat.
Kualitas tungku epitaxial silikon karbida terutama memiliki tiga indikator. Yang pertama adalah kinerja pertumbuhan epitaxial, termasuk keseragaman ketebalan, keseragaman doping, laju cacat dan tingkat pertumbuhan; Yang kedua adalah kinerja suhu peralatan itu sendiri, termasuk laju pemanasan/pendinginan, suhu maksimum, keseragaman suhu; dan akhirnya kinerja biaya peralatan itu sendiri, termasuk harga satuan dan kapasitas produksi.
CVD horizontal dinding panas, CVD planet dinding yang hangat dan CVD vertikal dinding kuasi-panas adalah solusi teknologi peralatan epitaxial utama yang telah diterapkan secara komersial pada tahap ini. Tiga peralatan teknis juga memiliki karakteristik sendiri dan dapat dipilih sesuai kebutuhan. Diagram struktur ditunjukkan pada gambar di bawah ini:

Sistem CVD horisontal dinding panas umumnya merupakan sistem pertumbuhan ukuran besar wafer tunggal yang digerakkan oleh pengapungan dan rotasi udara. Sangat mudah untuk mencapai indikator in-wafer yang baik. Model representatif adalah PE1O6 dari LPE Company di Italia. Mesin ini dapat mewujudkan pemuatan otomatis dan pembongkaran wafer di 900 ℃. Fitur utama adalah tingkat pertumbuhan tinggi, siklus epitaxial pendek, konsistensi yang baik di dalam wafer dan antara tungku, dll. Ini memiliki pangsa pasar tertinggi di Cina.

Menurut laporan resmi LPE, dikombinasikan dengan penggunaan pengguna utama, 100-150mm (4-6 inci) produk wafer epitaxial 4H-SIC dengan ketebalan kurang dari 30μM yang diproduksi oleh tungku epitaxial pe1o6 yang tidak stabil. Kepadatan ≤1cm-2, area bebas cacat permukaan (sel unit 2mm × 2mm) ≥90%.
Perusahaan-perusahaan domestik seperti JSG, CETC 48, Naura, dan NASO telah mengembangkan peralatan epitaxial silikon karbida monolitik dengan fungsi yang sama dan telah mencapai pengiriman skala besar. Misalnya, pada bulan Februari 2023, JSG merilis peralatan epitaxial SIC double-wafer 6-inci. Peralatan menggunakan lapisan atas dan bawah dari lapisan atas dan bawah bagian grafit dari ruang reaksi untuk menumbuhkan dua wafer epitaxial dalam satu tungku tunggal, dan gas proses atas dan bawah dapat diatur secara terpisah, dengan perbedaan suhu ≤5 ° C, yang secara efektif menebus bagian kunci yang tidak cukup.SIC Coating Halfmoon Parts. Kami memasok bagian Halfmoon 6 inci dan 8 inci untuk pengguna.

Sistem CVD planet-dinding hangat, dengan pengaturan planet basis, ditandai dengan pertumbuhan beberapa wafer dalam tungku tunggal dan efisiensi output tinggi. Model yang representatif adalah AIXG5WWC (8x150mm) dan G10-SIC (9 × 150mm atau 6 × 200mm) Seri Epitaxial Equipment Epitaxial dari Aixtron dari Jerman.
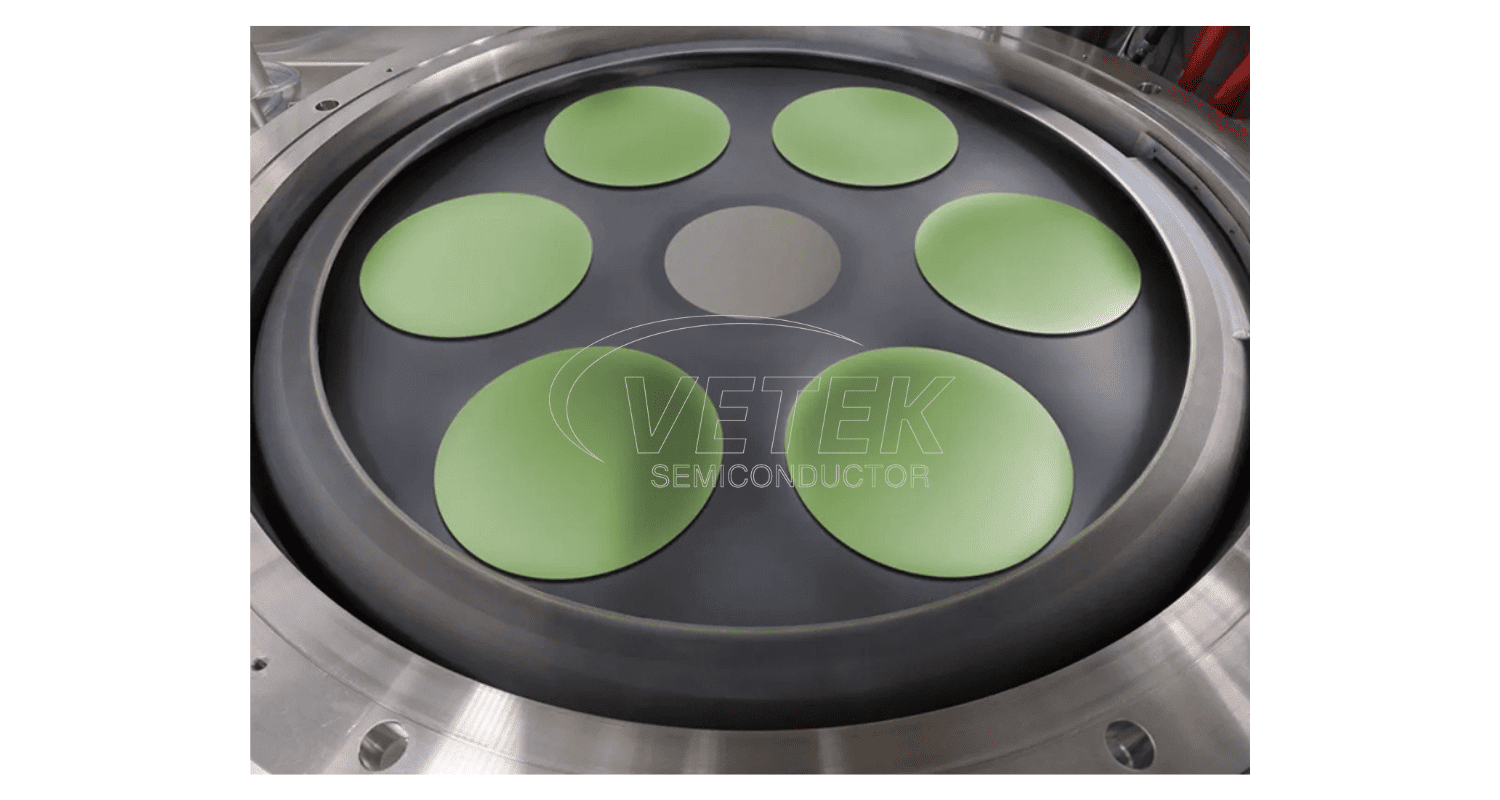
According to Aixtron's official report, the 6-inch 4H-SiC epitaxial wafer products with a thickness of 10μm produced by the G10 epitaxial furnace can stably achieve the following indicators: inter-wafer epitaxial thickness deviation of ±2.5%, intra-wafer epitaxial thickness non-uniformity of 2%, inter-wafer doping concentration deviation of ±5%, intra-wafer doping Konsentrasi non-keseragaman <2%.
Sampai sekarang, jenis model ini jarang digunakan oleh pengguna domestik, dan data produksi batch tidak cukup, yang sampai batas tertentu membatasi aplikasi rekayasa. Selain itu, karena hambatan teknis yang tinggi dari tungku epitaxial multi-wafer dalam hal kontrol bidang suhu dan aliran lapangan, pengembangan peralatan domestik yang serupa masih dalam tahap penelitian dan pengembangan, dan tidak ada model alternatif. Sementara itu, kami dapat memberikan kerentanan planet Aixtron seperti 6 inci dan 8 inci dengan pelapisan TAC atau pelapisan SIC.
Sistem CVD vertikal quasi-hot-wall terutama berputar pada kecepatan tinggi melalui bantuan mekanik eksternal. Karakteristiknya adalah bahwa ketebalan lapisan kental secara efektif dikurangi dengan tekanan ruang reaksi yang lebih rendah, sehingga meningkatkan laju pertumbuhan epitaxial. Pada saat yang sama, ruang reaksinya tidak memiliki dinding atas di mana partikel SIC dapat diendapkan, dan tidak mudah untuk menghasilkan benda yang jatuh. Ini memiliki keunggulan yang melekat dalam kontrol cacat. Model representatif adalah tungku epitaxial wafer tunggal Epirevos6 dan Epirevos8 dari Nuflare Jepang.
Menurut NuFlare, laju pertumbuhan perangkat Epirevos6 dapat mencapai lebih dari 50μm/jam, dan kepadatan cacat permukaan wafer epitaxial dapat dikontrol di bawah 0,1cm -²; Dalam hal kontrol keseragaman, insinyur nuflare Yoshiaki Daigo melaporkan hasil keseragaman intra-wafer dari wafer epitaxial 6-inci setebal 10 μm yang ditanam menggunakan Epirevos6, dan ketebalan intra-wafer dan konsentrasi doping yang tidak ada keseragaman yang mencapai 1% dan 2,6% masing-masing. Kami menyediakan SIC yang tidak dipadukan.Silinder grafit atas.
Saat ini, produsen peralatan domestik seperti Core Third Generation dan JSG telah merancang dan meluncurkan peralatan epitaxial dengan fungsi yang sama, tetapi mereka belum digunakan dalam skala besar.
Secara umum, tiga jenis peralatan memiliki karakteristik sendiri dan menempati pangsa pasar tertentu dalam kebutuhan aplikasi yang berbeda:
Struktur CVD horisontal dinding panas memiliki laju pertumbuhan yang sangat cepat, kualitas dan keseragaman, operasi dan pemeliharaan peralatan sederhana, dan aplikasi produksi skala besar yang matang. Namun, karena jenis wafer tunggal dan pemeliharaan yang sering, efisiensi produksi rendah; CVD planet dinding yang hangat umumnya mengadopsi 6 (bagian) × 100 mm (4 inci) atau 8 (potongan) × 150 mm (6 inci) struktur baki, yang sangat meningkatkan efisiensi produksi peralatan dalam hal kapasitas produksi, tetapi sulit untuk mengendalikan konsistensi beberapa bagian, dan hasil produksi masih merupakan masalah terbesar; CVD vertikal dinding kuasi-panas memiliki struktur yang kompleks, dan kontrol kualitas cacat produksi wafer epitaxial sangat baik, yang membutuhkan pemeliharaan peralatan yang sangat kaya dan pengalaman penggunaan.
Tingkat pertumbuhan cepat
sederhana struktur peralatan dan
pemeliharaan yang nyaman
Kapasitas produksi besar
efisiensi produksi yang tinggi
Kontrol Cacat Produk yang Baik
Ruang Reaksi Panjang
siklus pemeliharaan
Struktur kompleks
sulit dikendalikan
konsistensi produk
Struktur peralatan yang kompleks,
pemeliharaan yang sulit
Perwakilan
peralatan
produsen
CVD horizontal dinding panas
CWD planet dinding hangat
CTD vertikal dinding semu-panas
Keuntungan
Kerugian
Siklus perawatan pendek
Italia LPE, Japan Tel
Jerman Aixtron
Jepang Nuflare
Dengan pengembangan industri yang berkelanjutan, ketiga jenis peralatan ini akan dioptimalkan dan ditingkatkan secara iteratif dalam hal struktur, dan konfigurasi peralatan akan menjadi lebih dan lebih sempurna, memainkan peran penting dalam mencocokkan spesifikasi wafer epitaxial dengan ketebalan yang berbeda dan persyaratan cacat.



+86-579-87223657


Jalan Wangda, Jalan Ziyang, Kabupaten Wuyi, Kota Jinhua, Provinsi Zhejiang, Tiongkok
Hak Cipta © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Semua Hak Dilindungi Undang-undang.
Links | Sitemap | RSS | XML | Kebijakan Privasi |
